
为客户提供最专业的PCB行业服务
- 服务热线:13824363925

 行业资讯
行业资讯 


0
 2020-07-22 17:32:31
2020-07-22 17:32:31

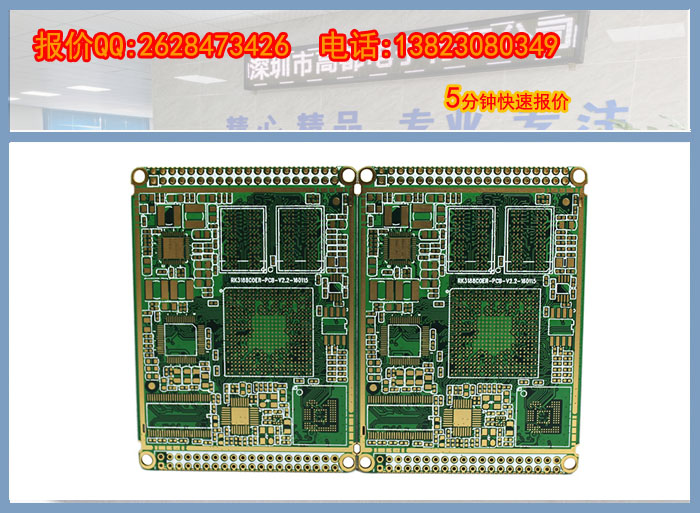 经过三次高温后,沉金板的焊点已满,而光亮的OSP板经过三次高温焊接后,焊点已变黑。经过三次高温焊接,可以看出沉金板卡焊点饱满光亮,对焊膏和焊剂的活性没有影响。然而,OSP的板卡焊点工艺是黑暗和沉闷的,这影响了焊膏和焊剂的活性,并且容易导致空焊和增加返工。
经过三次高温后,沉金板的焊点已满,而光亮的OSP板经过三次高温焊接后,焊点已变黑。经过三次高温焊接,可以看出沉金板卡焊点饱满光亮,对焊膏和焊剂的活性没有影响。然而,OSP的板卡焊点工艺是黑暗和沉闷的,这影响了焊膏和焊剂的活性,并且容易导致空焊和增加返工。双面板免费加费,四层板加急打样,厚铜电路板打样